Бесконтактное определение характеристик аморфного и микрокристаллического кремния с помощью микроспектроскопии комбинационного рассеяния
|
Тонкопленочные слои кремния широко применяются в солнечных панелях, фотоэлектрических устройствах и тонкопленочных транзисторах, например для TFT-экранов. На протяжении последних нескольких лет солнечные элементы на основе кремния, принадлежащие к области возобновляемой энергетики, приобрели особую актуальность, т.к. они позволяют решить проблему глобального потепления, вызванную потреблением ископаемого топлива. В частности, тонкопленочные солнечные элементы с чередованием микрокристаллических (мкКл Si:H) и аморфных (а-Si:H) слоев все чаще используются для выработки фотоэлектрической электроэнергии. Стоимость изготовления тонкопленочных модулей, как правило, ниже стоимости изготовления модулей из кристаллического кремния на подложке. Потенциал сокращения затрат обусловлен экономией на сырья и энергии. Аморфный и микрокристаллический кремнийСпектроскопия комбинационного рассеяния, и в частности, комбинационная микроскопия, является неразрушающим методом, который идеально подходит для бесконтактного анализа с высоким пространственным разрешением. Поэтому спектроскопия комбинационного рассеяния считается важным методом определения характеристик тонкопленочных слоев кремния. Спектры комбинационного рассеяния различных форм кремния подробно описаны в литературе. Спектры комбинационного рассеяния монокристаллического кремния (подложки), микрокристаллического кремния и аморфного кремния на стеклянной подложке показаны на рисунке 1. Монокристаллический кремний (Кл-Si) имеет резкую и симметричную фононную полосу на отметке примерно 520 см-1. У микрокристаллическая кремния фононная полоса наблюдается, как правило, на отметке 515 см-1. Спектр комбинационного рассеяния аморфного кремния, как правило, характеризуется четырьмя полосами с наиболее интенсивным пиком на отметке 480 см-1 (режим ТО). Другие режимы встречаются при 380 см-1 (режим LO), 301 см-1 (режим LA) и 150 см-1 (режим ТА). Спектроскопии комбинационного рассеяния позволяет определить различные свойства тонкопленочных пленки кремния, такие как напряжение, объемная доля аморфного/кристаллического кремния и размер кристаллов. Линии комбинационного рассеяния смещаются и расширяются в направлении от кристаллического к аморфному состоянию, что позволяет различать и количественно оценивать поли-, моно-, микро- (также известную как нано-) кристаллическую и аморфную фазы. Спектр комбинационного рассеяния слоя микрокристаллического кремния в микроморфной тандемной ячейке, показанный на рисунке 2, можно разделить на три элемента: Относительно резкая линия с центром около 515 см-1, соответствующая микрокристаллической фазе, пик с центром около 510 см-1, связанный с дефектной кристаллической фазой, и широкая полоса на отметке 480 см-1, соответствующая аморфной фазе. Отношение кристаллической и аморфной фракции сигналов комбинационного рассеяния может использоваться в качестве показателя кристаллической фракции в тонкопленочных солнечных элементах. Отношение кристаллической и аморфной фракции дает представление об электрических свойствах. Соотношение и форма микрокристаллических и аморфных полос могут быть использованы для оптимизации параметров производства, таких как температура осаждения или разбавление водородом, а также для контроля однородности солнечных модулей. |
Рисунок 1: Синий: спектр комбинационного рассеяния кремниевой подложки, красный: спектр комбинационного рассеяния микрокристаллического кремния на стекле, черный: спектр комбинационного рассеяния аморфного кремния на стекле.
Рисунок 2: Деконволюция спектра комбинационного рассеяния микрокристаллического слоя в микроморфной тандемной ячейке методом полосового анализа. Синий: Спектр комбинационного рассеяния (смещен для ясности) Красный: совпадающий спектр Черный: Пик с центром на отметке около 515 см-1, что соответствует микрокристаллической фазе Желтый: Пик с центром на отметке около 510 см-1, что соответствует дефектной кристаллической фазе Зеленый: Широкая полоса около 480 см-1 соответствует аморфной фазе. Кристаллический кремнийСдвиг пика комбинационного рассеяния позволяет определить не только степень кристалличности, но и остаточное напряжение структуры поверхности кремния. Например, сжимающее напряжение приводит к повышению, а растягивающее напряжение - к понижению фононной линии. На рисунке 3 представлена полученная методом комбинационного рассеяния схема (210 мкм х 160 мкм) контакта между алмазом и кристаллическим кремнием. Темная область соответствует зоне контакта между поверхностью кремния и алмазом. Наблюдался существенный сдвиг пика фононной линии к более низким волновым числам (рисунок 4). |
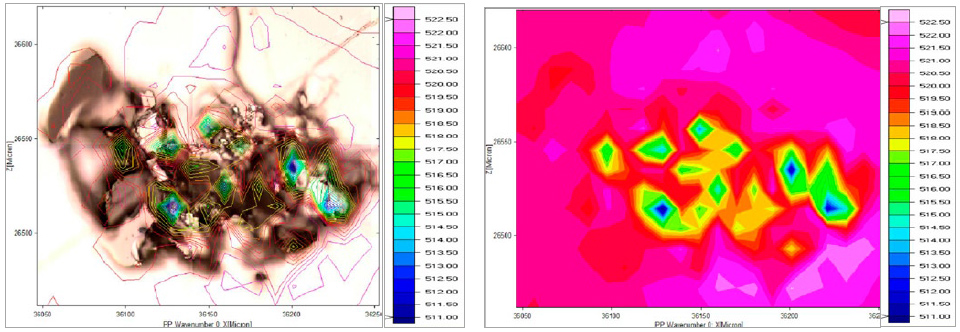
Рисунок 3. Схема, полученная методом комбинационного рассеяния, показывает изменения кристалличности, вызванные принудительным контактом алмаза с монокристаллическим кремнием. 2D-изображение (левое изображение поверх видеоизображения) показывает положение фононной полосы над анализируемой областью. Возбуждающий лазер 532 нм, 0,5 мВт, площадь: 210 мкм х 160 мкм, объектив микроскопа: 50x, время интегрирования: 1 сек на спектр.
|
Рисунок 4: Спектр комбинационного рассеяния показывает смещение линии и расширение пика вследствие изменений кристалличности, вызванных принудительным контактом алмаза с монокристаллическим кремнием; лазер 532 нм.
Рисунок 5: Схема, полученная методом комбинационного рассеяния, показывает изменения кристалличности, вызванные принудительным контактом алмаза с кремниевой подложкой. 3D-изображение показывает изменение ширины (FWHM) фононной линии на отметке 520 см-1. Возбуждающий лазер 532 нм, 0,5 мВт, площадь: 210 мкм х 160 мкм, объектив микроскопа: 50x, время интегрирования: 1 сек на спектр.
Рисунок 6: Схема поликристаллического кремния, полученная методом комбинационного рассеяния (6c), показывает сдвиги пика порядка 0,5 см-1, вызванные локальными изменениями степени кристалличности. 6а: Общий вид 6b: Анализируемая область, показывающая положение фононной зоны 6с: 3D-изображение, полученное методом комбинационного рассеяния Возбуждающий лазер 532 нм, 0,5 мВт, площадь: 36 мкм х 36 мкм, пространственное разрешение: 2 мкм, объектив микроскопа: 100x, время интегрирования: 1 сек на спектр. |
Это противоречит общему правилу о том, что напряжение сжатия приводит к сдвигу в сторону более высоких волновых чисел. Очевидно, что сравнительно большой сдвиг комбинационного рассеяния, составляющий 4 см-1, может быть связан с изменением степени кристалличности, а не со сжимающим напряжением. Кроме того, фононные линии, расположенные близко к зонам образования трещин в поверхности кремния под действием алмаза, были значительно расширены до 4 см-1 (рис 4 и 5). Сильное уширение фононных линий четко показывает, что следствием контакта стало преимущественно изменение кристалличности, а не сжатие. Поликристаллический кремнийСдвиг полосы на поверхности кремния может быть относительно небольшим. Так, на рисунке 6 показан определенный спектроскопией комбинационного рассеяния сдвиг пика в двух по-разному кристаллизованных зонах поликристаллического кремния. Сдвиг пика находится в диапазоне нескольких десятых волнового числа (рис. 7). Поэтому стабильность волнового числа имеет ключевое значение как для высокоточного определения сдвигов полос при выполнении исследований, так и для текущего контроля качества в лабораториях. Спектрометры комбинационного рассеяния компании Bruker, в том числе SENTERRA, имеют функцию автоматизированной и непрерывной калибровки оси волновых чисел. Благодаря запатентованной технологии Sure_Cal®, спектрометры комбинационного рассеяния Bruker автоматически калибруются точнее 0,1 см-1 без необходимости ручной регулировки. Помимо решений для анализа кристалличности кремния с помощью спектроскопии комбинационного рассеяния, компания Bruker также предлагает решения в области ИК-Фурье-спектроскопии для анализа примесей в поли- и монокристаллическом кремнии на основе соответствующих международных стандартов ASTM SEMI. Предлагается широкий спектр решений - от текущего анализа на углерод и кислород при комнатной температуре до автоматизированного низкотемпературного анализа с помощью уникальной системы CryoSAS. Экспериментальная частьОписанные в настоящей работе измерения были выполнены с использованием микроскопа комбинационного рассеяния SENTERRA и объективов 50x и 100x MPLN Olympus с возбуждающим лазером 532 нм. Важно отметить, что использование возбуждающего лазера влияет на глубину проникновения. Так, при использовании возбуждающего лазера 532 нм глубина проникновения составляет около 100 нм для а-Si:H, 300 нм для мкКл-Si:H и 1 мкм для Кл-Si [1]. Кроме того, образцы кремния чувствительны к нагреву. Для предотвращения нагрева образца и последующей рекристаллизации плотность мощности падающего лазера должна быть достаточно низкой. Мощность лазера поддерживалась на уровне 0,5 мВт для всех образцов.
Рисунок 7: Спектры комбинационного рассеяния поликристаллического кремния (см. рис. 6) показывают сдвиг спектрального пика фононной линии при 521 см-1 до 0,5 см-1 вследствие локальных изменений кристалличности; лазер 532 нм. ВыводыСпектроскопия комбинационного рассеяния является идеальным методом для определения характеристик кристаллической/аморфной фракции тонкопленочных солнечных элементов. Отношение микрокристаллической фазы прямо характеризует электрические свойства, а также качество солнечного элемента. Доказано, что микроскопия комбинационного рассеяния является эффективным и чувствительным методом определения небольших изменений в кристалличности. Поскольку спектроскопия комбинационного рассеяния позволяет получить данные о кристалличности быстро и бесконтактным способом, она идеально подходит для применения на технологических линиях. [1] A.V. Shah, H. Schade, M. Vanecek, J. Meier, E. Vallat-Sauvain, N. Wyrsch, U. Kroll, C.Droz and J.Bailat, Prog. Photovolt: Res Appl. 12, 113 (2004) |